رمز الاستجابة السريعة

معلومات عنا
منتجات
اتصل بنا

هاتف

فاكس
+86-579-87223657

بريد إلكتروني

عنوان
طريق وانغدا، شارع زيانغ، مقاطعة وويي، مدينة جينهوا، مقاطعة تشجيانغ، الصين
الطرق الرئيسية لتنمية البلورات الفردية SIC هي:نقل البخار المادي (PVT), ترسب بخار كيميائي مرتفع درجات الحرارة (HTCVD)ونمو محلول درجة الحرارة العالية (HTSG). كما هو مبين في الشكل 1. من بينها ، فإن طريقة PVT هي الطريقة الأكثر نضجًا واستخدامها على نطاق واسع في هذه المرحلة. في الوقت الحاضر ، تم تصنيع الركيزة البلورية الفردية مقاس 6 بوصات ، كما نمت Cree في الولايات المتحدة في الولايات المتحدة في الولايات المتحدة في عام 2016. ومع ذلك ، فإن هذه الطريقة لها قيود مثل كثافة العيوب المرتفعة ، وتوسع العائد المنخفض ، وتوسع القطر الصعبة ، وارتفاع التكلفة.
تستخدم طريقة HTCVD مبدأ أن مصدر Si Source و C Source Gas يتفاعلون كيميائيًا لتوليد SIC في بيئة عالية من درجة الحرارة تبلغ حوالي 2100 ℃ لتحقيق نمو البلورات المفردة SIC. مثل طريقة PVT ، تتطلب هذه الطريقة أيضًا درجة حرارة نمو عالية ولها تكلفة نمو عالية. تختلف طريقة HTSG عن الطريقتين أعلاه. مبدأها الأساسي هو استخدام حل وعناصر Si و C في حل درجة حرارة عالية لتحقيق نمو البلورات المفردة. النموذج الفني المستخدم على نطاق واسع هو طريقة TSSG.
يمكن أن تحقق هذه الطريقة نمو SIC في حالة توازن شبه ديناميكية عند درجة حرارة أقل (أقل من 2000 درجة مئوية) ، والبلورات المزروعة لها مزايا ذات جودة عالية ، منخفضة التكلفة ، توسع القطر السهل ، وسهولة مخطئة P-type. من المتوقع أن يصبح وسيلة لإعداد بلورات واحدة أكبر وذات الجودة العالية وأقل تكلفة بعد طريقة PVT.
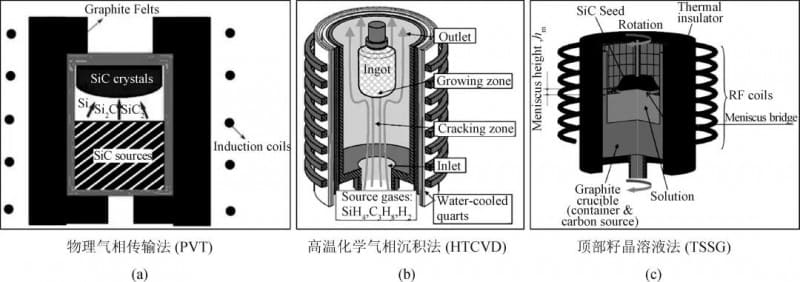
الشكل 1. مخطط تخطيطي لمبادئ ثلاث تقنيات النمو البلورية الفردية SIC
طريقة HTSG لتنمية SIC لها تاريخ أكثر من 60 عامًا.
في عام 1961 ، هالدن وآخرون. تم الحصول عليها لأول مرة بلورات واحدة من SIC من ذوبان Si عالي درجة الحرارة تم حلها فيها ، ثم استكشاف نمو البلورات الفردية SIC من محلول درجات الحرارة العالية يتكون من Si+X (حيث X هو واحد أو أكثر من العناصر Fe و Cr و SC و Tb و Pr ، إلخ).
في عام 1999 ، هوفمان وآخرون. من جامعة إرلانغن في ألمانيا ، استخدمت SI Pure Ceffilux واستخدمت طريقة TSSG ذات درجة الحرارة العالية والضغط عالي الضغط لتنمو بلورات واحدة كذا بقطر 1.4 بوصة وسمك حوالي 1 مم للمرة الأولى.
في عام 2000 ، قاموا بتحسين العملية بشكل أكبر ونمت بلورات كذا بقطر 20-30 ملم وسمك يصل إلى 20 مم باستخدام SI النقي كتدفق ذاتي في جو عالي الضغط من 100-200 بار في 1900-2400 درجة مئوية.
منذ ذلك الحين ، أجرى الباحثون في اليابان وكوريا الجنوبية وفرنسا والصين ودول أخرى على التوالي أبحاثًا حول نمو ركائز البلورة الفردية SIC بواسطة طريقة TSSG ، والتي جعلت طريقة TSSG تتطور بسرعة في السنوات الأخيرة. من بينهم ، يتم تمثيل اليابان من قبل Sumitomo Metal و Toyota. يوضح الجدول 1 والشكل 2 التقدم البحثي للمعادن السوميتومو في نمو البلورات الفردية SIC ، ويوضح الجدول 2 والشكل 3 عملية البحث الرئيسية والنتائج التمثيلية لتويوتا.
بدأ فريق البحث هذا في إجراء البحوث حول نمو بلورات SIC بواسطة طريقة TSSG في عام 2016 ، وحصل بنجاح على بلورة 4H SIC بحجم 2 بوصة بسمك 10 مم. في الآونة الأخيرة ، نما الفريق بنجاح بلورة بحجم 4 بوصات 4H ، كما هو مبين في الشكل 4.
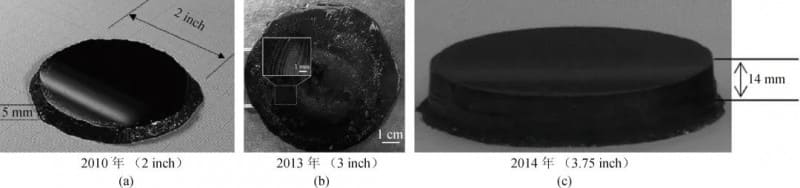
الشكل 2.الصورة البصرية للكريستال الذي يزرعه فريق Sumitomo Metal باستخدام طريقة TSSG

الشكل 3.إنجازات تمثيلية لفريق تويوتا في تنمو بلورات SIC الفردية باستخدام طريقة TSSG
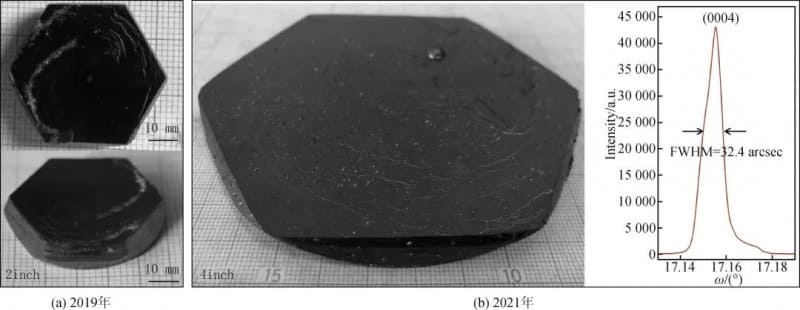
الشكل 4. إنجازات تمثيلية لمعهد الفيزياء ، الأكاديمية الصينية للعلوم ، في بلورات SIC المفردة باستخدام طريقة TSSG
SIC ليس لديه نقطة انصهار عند الضغط الطبيعي. عندما تصل درجة الحرارة إلى أعلى من 2000 ℃ ، فإنها ستتحلل مباشرة. لذلك ، ليس من الممكن أن تنمو بلورات واحدة من خلال التبريد ببطء وتوطيد ذوبان SIC من نفس التكوين ، أي طريقة الذوبان.
وفقًا لمخطط المرحلة الثنائية SI-C ، هناك منطقة ثنائية الطور من "L+SIC" في الطرف الغني بـ Si ، مما يوفر إمكانية نمو المرحلة السائلة لـ SIC. ومع ذلك ، فإن قابلية ذوبان Si Pure لـ C منخفضة للغاية ، لذلك من الضروري إضافة تدفق إلى Si Melt للمساعدة في زيادة تركيز C في محلول درجة الحرارة العالية. في الوقت الحاضر ، فإن الوضع الفني السائد لتنمية البلورات الفردية SIC بواسطة طريقة HTSG هو طريقة TSSG. الشكل 5 (أ) هو مخطط تخطيطي لمبدأ البلورات المفردة SIC بواسطة طريقة TSSG.
من بينها ، فإن تنظيم الخواص الديناميكية الحرارية للمحلول ذي درجة الحرارة العالية وديناميات عملية النقل المذاب وواجهة نمو البلورة لتحقيق توازن ديناميكي جيد للتوريد والطلب من المذاب C في نظام النمو بأكمله هو مفتاح إدراك بشكل أفضل نمو البلورات الفردية SIC بواسطة طريقة TSSG.
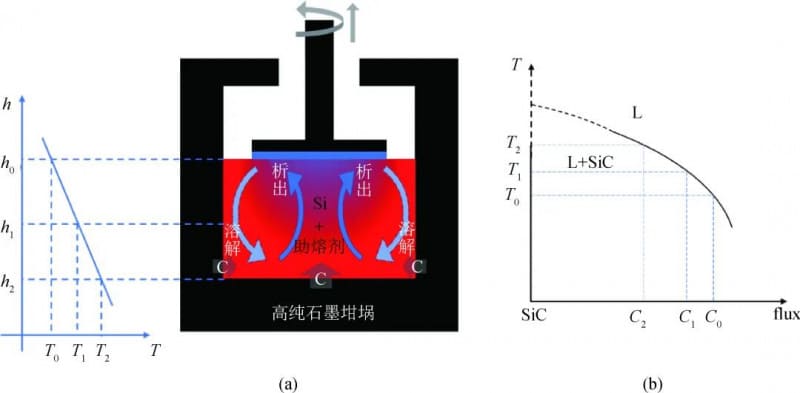
الشكل 5. (أ) رسم تخطيطي لنمو البلورة الفردية SIC بواسطة طريقة TSSG ؛ (ب) رسم تخطيطي للقسم الطولي من منطقة L+SIC ثنائية الطور
إن إذابة ما يكفي من C إلى حلول درجات الحرارة العالية هو المفتاح لتنمية البلورات الفردية SIC بواسطة طريقة TSSG. تعد إضافة عناصر التدفق وسيلة فعالة لزيادة قابلية ذوبان C في حلول درجة الحرارة العالية.
في الوقت نفسه ، ستنظم إضافة عناصر التدفق أيضًا الكثافة والزوجة والتوتر السطحي ونقطة التجمد والمعلمات الديناميكية الحرارية الأخرى للحلول ذات درجة الحرارة المرتفعة المرتبطة ارتباطًا وثيقًا بالنمو البلوري ، مما يؤثر بشكل مباشر على العمليات الديناميكية الحرارية والحركية في نمو البلورة. لذلك ، فإن اختيار عناصر التدفق هو الخطوة الأكثر أهمية في تحقيق طريقة TSSG لتنمية بلورات SIC المفردة وهي التركيز البحثي في هذا المجال.
هناك العديد من أنظمة حلول درجة الحرارة الثنائية التي تم الإبلاغ عنها في الأدبيات ، بما في ذلك Li-Si و Ti-Si و CR-Si و Fe-Si و SC-Si و Ni-Si و Co-Si. من بينها ، تم تطوير الأنظمة الثنائية لـ CR-Si و Ti-Si و Fe-Si والأنظمة متعددة المكونات مثل CR-CE-AL-Si بشكل جيد وحصلت على نتائج جيدة للنمو البلوري.
يوضح الشكل 6 (أ) العلاقة بين معدل نمو SIC ودرجة الحرارة في ثلاثة أنظمة مختلفة من حلول درجة الحرارة العالية من CR-Si و Ti-Si و Fe-Si ، التي يلخصها Kawanishi et al. جامعة توهوكو في اليابان في عام 2020.
كما هو مبين في الشكل 6 (ب) ، Hyun et al. صمم سلسلة من أنظمة حلول درجة الحرارة العالية مع نسبة تكوين من Si0.56Cr0.4m0.04 (M = SC ، Ti ، V ، Cr ، Mn ، Fe ، Co ، Ni ، Cu ، Rh و Pd) لإظهار قابلية ذوبان C.

الشكل 6. (أ) العلاقة بين معدل نمو البلورة الواحد الكوارث ودرجة الحرارة عند استخدام أنظمة حلول درجات الحرارة العالية المختلفة
من أجل الحصول على بلورات فردية عالية الجودة بشكل أفضل ، من الضروري أيضًا تنظيم حركية هطول الأمطار البلورية. لذلك ، فإن التركيز الأبحاث الآخر لطريقة TSSG لتنمية البلورات الفردية SIC هو تنظيم الحركية في حلول درجات الحرارة العالية وفي واجهة نمو البلورة.
تشمل الوسيلة الرئيسية للتنظيم: عملية الدوران وسحب بلورة البذور والمكلووتات ، وتنظيم مجال درجة الحرارة في نظام النمو ، وتحسين بنية بوتقة وحجم ، وتنظيم الحمل الحراري للمحلول في درجة الحرارة العالية عن طريق المجال المغناطيسي الخارجي. الغرض الأساسي هو تنظيم حقل درجة الحرارة وحقل التدفق وحقل تركيز المذاب في الواجهة بين محلول درجة الحرارة العالية والنمو البلوري ، وذلك لتحسين حقل أفضل وأسرع من محلول درجة الحرارة العالية بطريقة منظمة وتنمو إلى بلورات فردية عالية الحجم عالية الجودة.
لقد جرب الباحثون العديد من الطرق لتحقيق التنظيم الديناميكي ، مثل "تقنية الدوران المتسارع بوتقة" التي يستخدمها Kusunoki et al. في أعمالهم المبلغ عنها في عام 2006 ، و "تقنية نمو الحلول المقعرة" التي طورتها Daikoku et al.
في عام 2014 ، Kusunoki et al. تمت إضافة بنية حلقة الجرافيت كدليل غمر (IG) في البوتقة لتحقيق تنظيم الحمل الحراري في حل درجات الحرارة العالية. من خلال تحسين حجم وموضع حلقة الجرافيت ، يمكن إنشاء وضع نقل موحد للأعلى في محلول درجات الحرارة العالية أسفل بلورة البذور ، وبالتالي تحسين معدل نمو البلورة وجودةه ، كما هو مبين في الشكل 7.

الشكل 7: (أ) نتائج محاكاة تدفق محلول درجة الحرارة العالية وتوزيع درجة الحرارة في بوتقة ؛
(ب) رسم تخطيطي للجهاز التجريبي وملخص النتائج
تنعكس مزايا طريقة TSSG في تنمو بلورات SIC الفردية في الجوانب التالية:
(1) طريقة حل درجات الحرارة العالية لزراعة البلورات المفردة SIC يمكنها إصلاح الأنابيب الدقيقة وغيرها من العيوب الكلية الأخرى في بلورة البذور ، وبالتالي تحسين جودة البلورة. في عام 1999 ، هوفمان وآخرون. لوحظ ومثبت من خلال المجهر البصري أنه يمكن تغطية الأنابيب الدقيقة بفعالية في عملية تنمو البلورات الفردية SIC بواسطة طريقة TSSG ، كما هو مبين في الشكل 8.
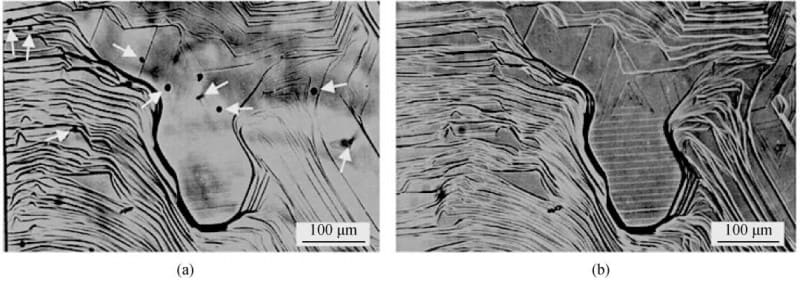
الشكل 8: القضاء على الأنابيب الدقيقة أثناء نمو البلورة الفردية SIC بواسطة طريقة TSSG:
(أ) صورة مجهرية بصرية للكريستال النيائي الذي يزرعه TSSG في وضع الإرسال ، حيث يمكن رؤية الأنابيب الدقيقة تحت طبقة النمو بوضوح ؛
(ب) صورة مجهرية بصرية لنفس المنطقة في وضع الانعكاس ، مما يشير إلى أن الأنابيب الدقيقة قد تمت تغطية بالكامل.
(2) بالمقارنة مع طريقة PVT ، يمكن أن تحقق طريقة TSSG بسهولة أكبر توسع قطر البلورة ، مما يزيد من قطر الركيزة البلورية المفردة ، مما يؤدي بشكل فعال إلى تحسين كفاءة إنتاج أجهزة SIC وتقليل تكاليف الإنتاج.
حققت فرق البحث ذات الصلة في تويوتا وشركة سوميتومو توسع قطر بلوري يمكن التحكم فيه بشكل مصطنع باستخدام تقنية "التحكم في ارتفاع الغضروف المفصلي" ، كما هو مبين في الشكل 9 (أ) و (ب).
الشكل 9: (أ) رسم تخطيطي لتكنولوجيا التحكم في الغضروف المفصلي في طريقة TSSG ؛
(ب) تغيير زاوية النمو θ مع ارتفاع الغضروف المفصلي والرؤية الجانبية للكريستال SIC الذي حصلت عليه هذه التكنولوجيا ؛
(ج) النمو لمدة 20 ساعة على ارتفاع الغضروف 2.5 ملم ؛
(د) النمو لمدة 10 ساعات على ارتفاع الغضروف المفصلي 0.5 ملم ؛
(هـ) النمو لمدة 35 ساعة ، مع ارتفاع ارتفاع الغضروف المفصلي تدريجياً من 1.5 مم إلى قيمة أكبر.
(3) مقارنة مع طريقة PVT ، من الأسهل تحقيق طريقة TSSG في المنشطات المستقرة من بلورات SIC. على سبيل المثال ، Shirai et al. من تويوتا ذكرت في عام 2014 أنها نمت بلورات P-type 4H-SIC منخفضة النشاط بواسطة طريقة TSSG ، كما هو مبين في الشكل 10.
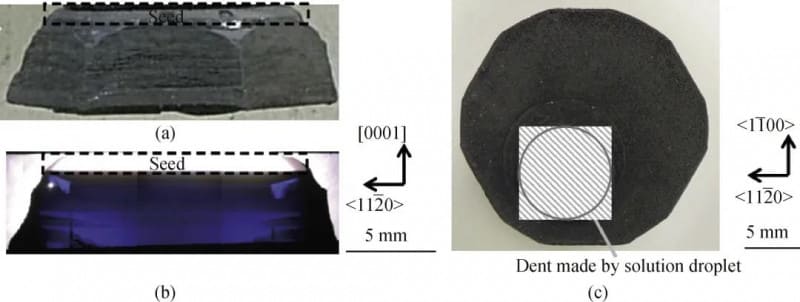
الشكل 10: (أ) العرض الجانبي للبلورة المفردة من نوع p-type التي تزرعها طريقة TSSG ؛
(ب) انتقال الصورة البصرية لقسم طولي من البلورة ؛
(ج) مورفولوجيا السطح العلوي من بلورة نمت من محلول درجة حرارة عالية مع محتوى AL بنسبة 3 ٪ (جزء ذري)
أحرزت طريقة TSSG لزراعة البلورات الفردية SIC تقدماً كبيراً في العشرين عامًا الماضية ، ونمت بعض الفرق من بلورات واحدة عالية الجودة بحجم 4 بوصات بواسطة طريقة TSSG.
ومع ذلك ، لا يزال التطوير الإضافي لهذه التكنولوجيا يتطلب اختراقات في الجوانب الرئيسية التالية:
(1) دراسة متعمقة للخصائص الديناميكية الحرارية للمحلول ؛
(2) التوازن بين معدل النمو وجودة البلورة ؛
(3) إنشاء ظروف نمو البلورة مستقرة ؛
(4) تطوير تكنولوجيا التحكم الديناميكية المكررة.
على الرغم من أن طريقة TSSG لا تزال وراء طريقة PVT إلى حد ما ، يُعتقد أنه مع الجهود المستمرة للباحثين في هذا المجال ، حيث يتم حل المشكلات العلمية الأساسية المتمثلة تطوير صناعة SIC.



+86-579-87223657


طريق وانغدا، شارع زيانغ، مقاطعة وويي، مدينة جينهوا، مقاطعة تشجيانغ، الصين
حقوق الطبع والنشر © 2024 VeTek Semiconductor Technology Co., Ltd. جميع الحقوق محفوظة.
Links | Sitemap | RSS | XML | Privacy Policy |
